|
 High-k gate dielectrics prepared by liquid phase anodic oxidation High-k gate dielectrics prepared by liquid phase anodic oxidation
|
刊登日期:2014/05/21 |
|
|
|
|
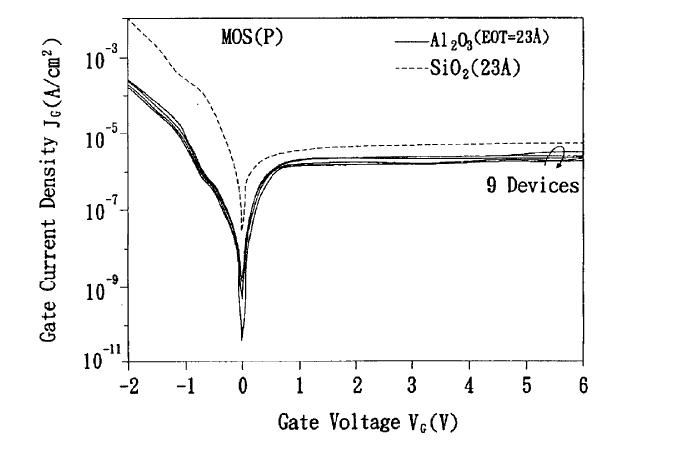
|
| ‧ 專利名稱 |
以液相陽極氧化技術成長高介常數閘極介電質之方法 |
| ‧ 專利證書號 |
192516
6887310
|
| ‧ 專利權人 |
國立臺灣大學 |
‧ 專利國家
(申請日) |
中華民國 (2002/06/10)
美國 (2002/07/17)
|
|
|
| |
| ‧ 發明人/PI |
胡振國,林彥伯,黃思維,
|
| ‧ 單位 |
電子工程學研究所
|
| ‧ 簡歷/Experience |
|
|
 技術摘要 / Our Technology: 技術摘要 / Our Technology: |
一種以液相陽極氧化技術成長高介電常數閘極介電質之方法,係先於一乾淨的矽基板表面上成長金屬薄膜,接著以液相陽極氧化法將該金屬薄膜氧化成金屬氧化物作為閘極氧化層,然後經過一道熱退火處理以提升氧化層品質;利用該技術可成長高品質、高介電常數、超薄等效氧化層厚度(Equivalent Oxide Thickness,EOT)的閘極介電層,且可直接與互補式金氧半電晶體(CMOS)製程整合。
High constant gate dielectrics are prepared by:
(a) providing a silicon substrate and a metallic film on the clean surface of the substrate;
(b) oxidizing the metallic film to form a metallic oxide as a gate oxidizing layer by liquid phase anodic oxidation; and
(c) promoting quality of the gate oxidizing layer by thermal annealing.
|
 市場需求 / Market Needs: 市場需求 / Market Needs: |
The liquid phase anodic oxidation effectively develops high-k gate dielectrics and produces ultra thin equivalent oxide thickness. It decreases leakage current of oxidizing layer and provides stable current driving ability to semiconductor device.
|
| |
 專利簡述 / Intellectual Properties: 專利簡述 / Intellectual Properties: |
|
| |
 聯繫方式 / Contact: 聯繫方式 / Contact: |
| 臺大產學合作總中心 / Center of Industry-Academia Collaboration, NTU |
|
| Email:ordiac@ntu.edu.tw |
電話/Tel:02-3366-9945 |
|
|
| |
|
| |
 |